Sub micron defect sensitivity
First system in the world to do wafer 3D & 2D analysis simultaneously
- Increase your yield with the most advanced A.I. in semiconductor metrology.
- BTBP's system detects and quantifies process defects.
- Wafer metrology is the key to process control and yield enhancement.


- Load & scan the wafer.
- Capture the full wafer for 2D and 3D analysis.
- Recipe setup and binning capability.
- Classify wafer defects and generate highest resolution 3D models for quantitative measurements.
- Detect & display defects like particles, scratches, missing patterns & bumps.
Highlights
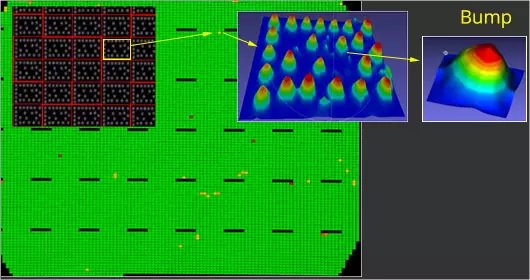
DETECTING THE DEFECTS
Bumps on the wafer:
- Identifying X, Y location(relative to notch), minimum height, maximum height, average height and diameter of the bump on a wafer.
- Information is saved in the industry standard KLARF format.

BINNING CAPABILITY
- Missing bumps can be identified.
- High quality imaging providing greater detail of intensities for detecting even floor variations & the height of bumps more accurately.

PARTICLES ON WAFER
- Features capable of detecting the presence of particles, residues, damaged wafers, wafer edges, hard & soft defects with their locations, count and size with high binning accuracy.
- 32 Bit High Dynamic Range Process of Scanning: Provides a wide range of intensities for detecting sub micron particles (0.25 microns) to very large particles (many millimeters) with a single scan for front and back of the wafer.
- Automatic classification of defects through our computer algorithm process of deep learning(A.I).